- Ameya360 Component Supply Platform >
- Trade news >
- 中国芯片制造产业发展难点在哪
中国芯片制造产业发展难点在哪
2021年,我国GDP规模达到114.4万亿元,一年内GDP增加13万亿元,这在中华民族历史上是第一次。2022年是进入全面建设社会主义现代化国家、向第二个百年奋斗目标进军新征程的重要一年。如何走好新的“赶考路”举世瞩目。
在这条新的“赶考路”上,我国的发展经受着来自外部的压力。压力之下,维护技术主权的重要性也是不言而喻的。在此当中半导体产业的自主研发能力及生产的能力更是决定了中国信息技术主权发展的重要因素。

半导体主要由四个部分组成:集成电路(IC: integrated circuit),光电器件,分立器件,传感器,由于集成电路又占了器件80%以上的份额,因此通常将半导体和集成电路等价。集成电路按照产品种类有主要分为四大类:微处理器,存储器,逻辑器件,模拟器件,这些我们又称它们为“芯片”。
半导体产业是支撑国家经济社会发展的战略性、基础性、先导性产业,也是我国当前需要重点突破的领域。它不仅支撑了庞大的生态,它的边界也在不断被延伸。从简单的计算与控制、数据、智能到感知与信号转换、能量变换再到AI、云计算、大数据、物联网、数字经济、信息安全等,它们无一例外地以芯片为基础。可以说半导体制造技术发展到位,我国科技领域才不会受制于人。
半导体制造业的发展壮大为什么那么难呢?我们从全局的角度简要了解下半导体制造工艺及面临的技术难点。
各种半导体产品
首先我们以汽车为例,介绍半导体技术所涉及的领域。从F-1赛车到大型拖车,应用目的不同,种类也多种多样。半导体产品同样根据衬底材料和应用的不同,来进行各种分类。其分类如图1所示。
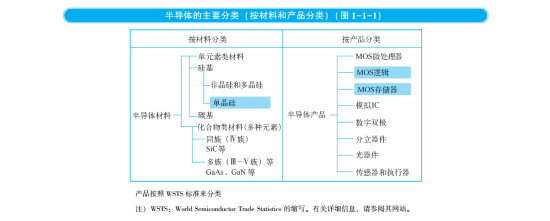
图1半导体的主要分类 (按材料和产品分类)
材料以单元素类材料和化合物类材料为主。硅半导体当然是单元素类,另外,化合物类材料主要用于按产品分类的光器件等。
说说半导体工艺
在半导体产业中,制造工程被称为工艺 (Process),理由是什么?虽然没有明确的答案,但很多人认为,与其说加工尺寸微小 (目前是nm制程。1nm=10-9m), 不如说制造过程无法用肉眼看到所致。例如像电视机和汽车这样的组装工程,因为是肉眼可见的,所以不能把制造工程称为工艺。此外,半导体产品还有一个特点,即不是一个一个生产, 而是批量生产,之后进行分割。因此,在半导体中,可能比较适合使用具有相对抽象含义的术语 “工艺” (Process)。
半导体工艺包含前段制程和后段制程。这里的前段制程主要是对硅晶圆进行加工,所以也被称为晶圆工艺 ( Wafer Process)。主要的6个工艺会反复多次进行, 称之为“循环型工艺”。化学工业常被称为 “工艺产业”,也是因为化学产品要经过热分解、聚合、蒸馏等工艺,故而得名。而且同样也是先大量生产,之后进行分装。与此相对应,后段制程包括封装工序,因此称之为从上游到下游的 “Flow型工艺”。
前段制程可以进一步分类为前端 (Front-End)和后端( Back-End)。前者主要是形成晶体管等元件, 而后者主要是形成布线。而且加工尺寸非常小, 只有几十nm(纳米),因此,硅晶圆的洁净度要求变得更加严格,而且对生产设备和晶圆厂(fab)的洁净度也有很高的要求,生产设备的价格也会更加昂贵,晶圆厂建设的投资额也会更加庞大。
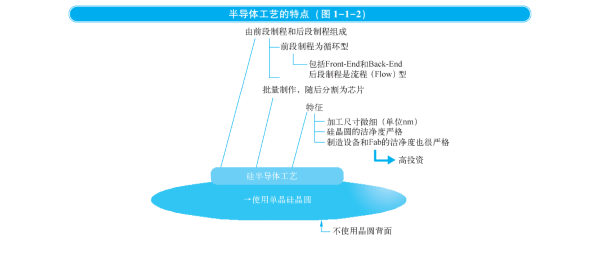
图2半导体工艺的特点
以上内容归纳在图2中,希望您牢记这张图。
另外,还要提到的是,本文所涉及的半导体工艺是在硅晶圆的表面 ( Mirror,镜面)上进行工艺加工,而不是在硅晶圆的背面(Sand Blast, 磨砂面)上进行工艺处理。突然冒出镜面和磨砂面两个词,可能让不熟悉晶圆的读者略感困惑,为此,下面对硅晶圆进行介绍。
硅晶圆是将单晶硅的硅锭用钢丝锯切成圆盘状。逻辑和存储器LSI都是只在晶圆表面上制作的,所以晶圆表面要做镜面抛光处理。如图2所示,因为像镜子一样光亮,所以叫作镜面。而另一面仅进行粗糙的研磨,不像镜子那样光亮,故而称为磨砂面。
在制作成芯片时,如图1.2所示, 通过后段制程中的工艺使晶圆变薄。
半导体制造面临的难点
半导体制造主要面临的难点,可总结为以下7点。
1. 材料纯度极高
所用晶圆纯度高达“11个9”,即99.999999999%,洁净度也比手术室的要求严格100倍。
2. 复杂度极大
集成了数百亿的晶体管,复杂程度可想而知。
3. 制程尺寸极小
晶体管的尺寸已经来到5nm的水平。
4. 设备极复杂
半导体对于精度和功能的要求很高,导致简单的工艺能很难满足高精尖的需求。所以需要很多复杂的设备参与生产,比如光刻机。光刻机的光源和光学反射系统都是相当复杂的系统。
5. 投资成本极大
建造一座10nm以下,并拥有产能10万片晶圆/月的晶圆厂需要百亿美元的规模。不光是设备,相关工艺研发也是同等数量级的。
6. 工作流程极长
设备繁多,多以串行处理贯穿制造始终,工作流程的设计、实行、监控要求很高。
7. 分工极细,融合极其紧密
从设计,EDA(电子设计自动化),设备和材料的相互融合,都是各大企业以数十年的行业基础推动而成的,使得后来者很难居上甚至介入。
Previous:尼得科全新一代微型驱动器Commander S
Next:2024 年后,芯片供应将缓解
Online messageinquiry

一文了解逻辑芯片和处理器芯片的关系

科技部长阴和俊:芯片攻关取得新突破!

一文了解闪存芯片和ROM关系
- Week of hot material
- Material in short supply seckilling
| model | brand | Quote |
|---|---|---|
| CDZVT2R20B | ROHM Semiconductor | |
| RB751G-40T2R | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| MC33074DR2G | onsemi | |
| BD71847AMWV-E2 | ROHM Semiconductor |
| model | brand | To snap up |
|---|---|---|
| ESR03EZPJ151 | ROHM Semiconductor | |
| TPS63050YFFR | Texas Instruments | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| BP3621 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| STM32F429IGT6 | STMicroelectronics |
Qr code of ameya360 official account
Identify TWO-DIMENSIONAL code, you can pay attention to


Please enter the verification code in the image below:






















