- Ameya360 Component Supply Platform >
- Trade news >
- 一片晶圆可以产出多少芯片
一片晶圆可以产出多少芯片
芯片的制造过程可以分为前道工艺和后道工艺。前道是指晶圆制造厂的加工过程,在空白的硅片完成电路加工,出厂后依然是完整的圆形硅片。后道是指封装和测试过程,在封测厂中将圆形的硅片切割成单独的晶粒,完成外壳的封装,最后完成终端测试,出厂为芯片成品。
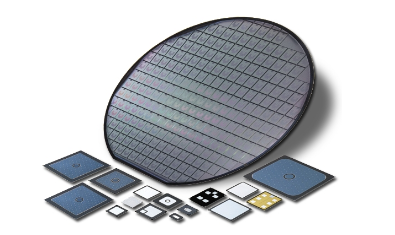
一片晶圆可以产出多少芯片取决于晶圆的大小,晶粒的大小和良率三个因素。本期我们将从这三个方面简单的展开说说。
一片wafer有多大?
晶圆,又称wafer, 常见的尺寸大小为6英寸、8英寸、12英寸等,换算成mm分别是150mm, 200mm,300mm, 这里的长度指的是晶圆的直径。由此可见,12寸的直径是8寸晶圆直径的1.5倍,12寸晶圆的面积为8寸晶圆的2.25倍。
什么是“Die”?
Die指的是芯片未封装前的晶粒,是从wafer上用激光切割而成的一个单独的晶圆区域,它包含了芯片的一个完整功能单元或一组相关功能单元。每个Die最终都切割成一个小方块并封装起来,成为我们常见的芯片。
晶圆的良率很重要
通常芯片的制造步骤会设计到几百步工艺,其相当长且很复杂。这些制程也不可能每次都很完美,因此晶圆的良率管控就显得尤其重要,同时良率对产品的成本也有着显著的影响。
晶圆可切割晶粒计算器 DPW
一片晶圆可以切出多少芯片?抛去良率因素,这是一个简单的图形面积计算问题,它的专有的表征名词是“DPW”,DPW是Die Per Wafer的缩略词。晶圆可切割晶粒数(DPW)的计算是非常简单的。它的计算实际上是与圆周率π有密切的关联。

晶圆上的晶粒其实可以看作是圆形所能容纳下的所有方形的集合。所以,可切割晶粒数的计算就是利用圆周率和晶圆尺寸作为已知参数,确定出整体圆形区域能容量下的方形数量。
π:圆周率
d: 晶圆直径
W: 晶粒长度
H: 晶粒宽度
晶圆尺寸和晶粒尺寸虽然是已知的,但是,由于晶粒相互之间是有空隙(如预留的划道)的,晶圆的边缘去除区也不可用。这些因素使得计算变得稍微有点复杂和棘手。因此,把DPW工具的计算结果作为可切割晶粒估算值而非精确的计算值可能更准确一点。
除了前面提到的无效区域外,晶圆厂还会额外占用部分区域做测试(PCM结构),相对而言也会占用晶圆一小部分面积。另外还有划道、晶圆裕量,以及因为各工序之间或晶圆厂之间要求不同而导致的测试结构大小不一致而浪费的区域。因此,如需精确的最终DPW数值应直接向晶圆厂问询,以得到更专业准确的数据。
Previous:北京君正集成电路多核异构跨界处理器X2000
Online messageinquiry

一文了解逻辑芯片和处理器芯片的关系

科技部长阴和俊:芯片攻关取得新突破!

一文了解闪存芯片和ROM关系
- Week of hot material
- Material in short supply seckilling
| model | brand | Quote |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| MC33074DR2G | onsemi | |
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor |
| model | brand | To snap up |
|---|---|---|
| STM32F429IGT6 | STMicroelectronics | |
| TPS63050YFFR | Texas Instruments | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| BP3621 | ROHM Semiconductor | |
| BU33JA2MNVX-CTL | ROHM Semiconductor |
Qr code of ameya360 official account
Identify TWO-DIMENSIONAL code, you can pay attention to


Please enter the verification code in the image below:






















